半导体研发卡脖子?AFM/SEM/EDS三合一显微镜让纳米级“病灶”显形
发布日期:2025-08-12
在半导体研发的微观世界里,7 nm 以下制程的晶圆突然出现不明短路,异质界面的失效反复上演,跨设备分析时同一感兴趣区域总是 “捉迷藏”…… 当传统检测手段在分辨率与效率间艰难妥协,一款集 SEM、AFM 和 EDS 于一体的 FusionScope 设备,正以 “三位一体” 的原位表征能力,为半导体行业撕开纳米级 “黑箱”,让形貌、结构与化学分析在同一视野里实时联动,成为破解工艺痛点的关键钥匙。
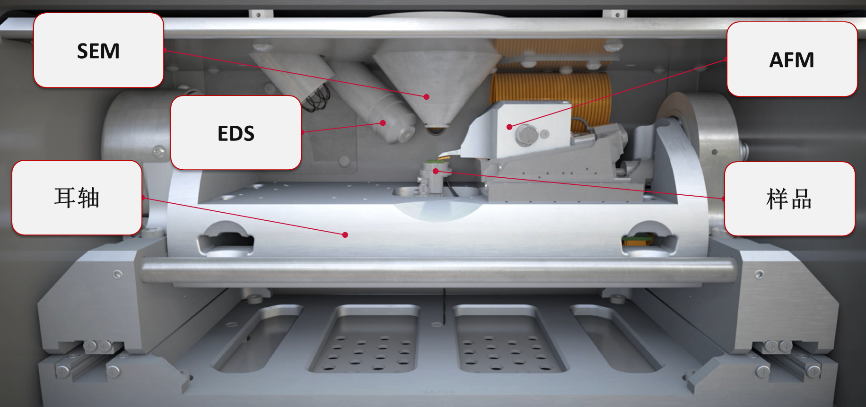
SEM/AFM/EDS三合一显微镜FusionScope结构图
本文将围绕 FusionScope 的核心破局优势展开,详细介绍其在半导体器件 “失效分析”、半导体研发 “高分辨检查”、半导体研发工艺中侧壁粗糙度 “质量检查” 以及半导体器件的纳米电学表征(包括纳米机械手辅助的 CAFM&EFM 表征、EBAC/EBIC 表征、EFM 表征)等方面的应用案例,展现其作为破解工艺痛点关键钥匙的强大实力。
FusionScope核心破局优势:
AFM-SEM-EDS共坐标系自研技术可实现:
三维形貌与二维结构像素级对齐(共坐标系统)
元素分布直接映射到特定形变区域(案例:捕获层间通孔界面)
真空环境全流程防护(规避大气暴露导致的表面氧化伪影)
可扩展功能(最多4个纳米机械手的扩展)
应用案例大合集:
1. FusionScope对半导体器件进行“失效分析”
在半导体制造中,失效分析与质量控制是提升良率的核心环节。以棘手的层间通孔电路为例,FusionScope的SEM、AFM和EDS的三重关联分析功能,大大增加了对样品的了解,有助于改进制备工艺。
首先,利用SEM在大面积区域成像,并通过提供详细的叠层误差成像来识别潜在故障点。当材料层不对齐时,会减少接触面积,并可能在某些情况下导致失效。SEM还提供了X轴和Y轴的高分辨率横向信息,有助于精确测量叠层精度。
FusionScope的共坐标系与SEM提供的坐标相结合,可以通过执行自动扫描命令轻松获得AFM测量结果。AFM数据提供的补充垂直表面信息揭示了表面沿Z轴的形貌细节,而这些细节在SEM图像中并不清晰。如下图所示,AFM显示电路线在层间通孔上变细,可能导致电学连接受损。
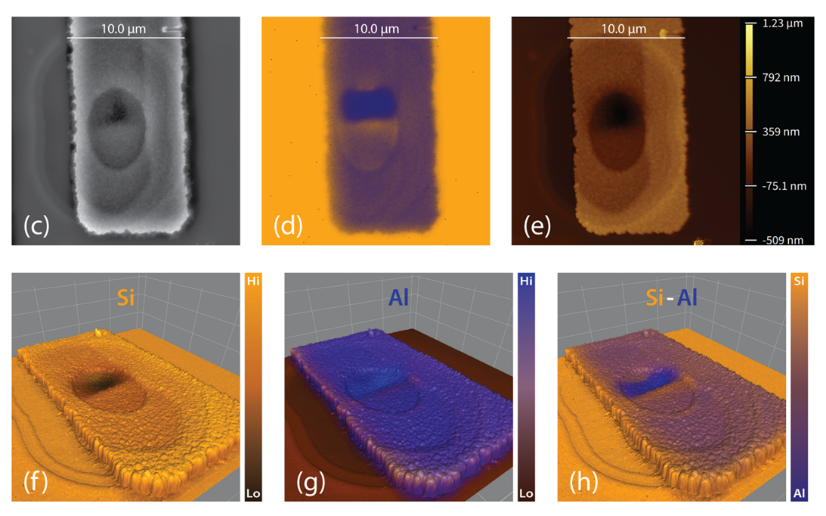
层间通孔电路SEM/AFM/EDS表征
2. FusionScope对半导体研发进行“高分辨检查”
对于纳米级台阶高度的控制,FusionScope 的高分辨率更是“细如发丝”。在半导体制造中,1 nm 的偏差就可能引发器件漏电或应力断裂,而FusionScope能轻松分辨 SrTiO3 衬底上单个原子层(约 0.4 nm)的厚度差异(如下图所示),为光刻对焦精度、金属互连可靠性与 3D 堆叠良率提供“纳米级标尺”。
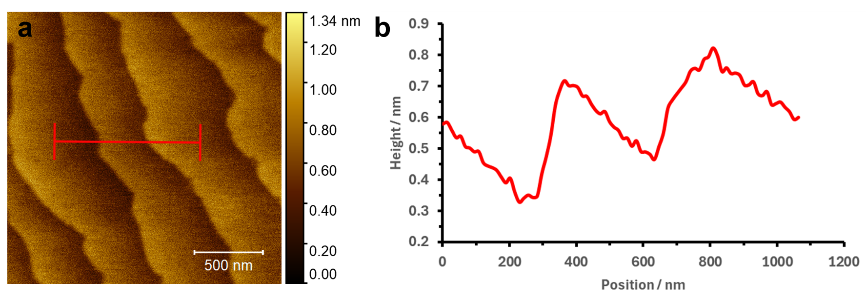
原子层台阶的AFM形貌表征
3. FusionScope在半导体研发工艺中侧壁粗糙度的“质量检查”
半导体器件表面与侧壁粗糙度的表征是决定芯片性能、可靠性和良率的纳米级标尺。通常,半导体器件的表面粗糙度相对容易表征,但半导体器件的侧壁粗糙度不容易表征。
FusionScope通过创新方案,精确定位到感兴趣区域,高效表征侧壁粗糙度:
借助纳米机械手的辅助,进行破坏性地掰断波导结构,然后定位到波导侧壁进行表征;
采用倾斜的样品台&耳轴的旋转相结合的方法,对半导体&玻璃基底的侧壁分别进行进行表面粗糙度表征。
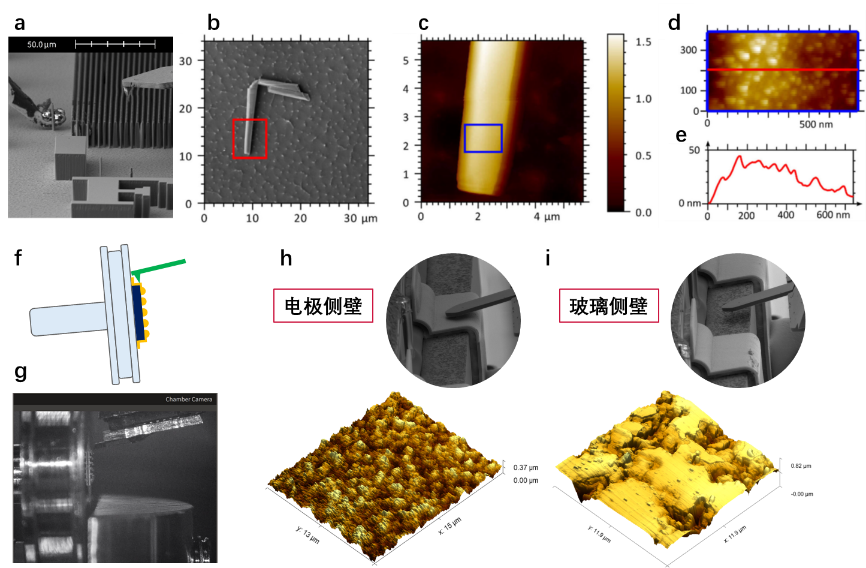
半导体器件侧壁粗糙度表征
4. FusionScope对半导体器件的纳米电学表征
1) 纳米机械手辅助的CAFM&EFM表征
Kleindiek的纳米机械手作为标准SEM成熟的集成组件,其易于集成和出色的稳定性,能够实现亚纳米级的高精度移动,可以实现从机械操作到电学性质测试,以及电子束诱导电流(EBIC)表征。FusionScope系统中,最多可实现四个Kleindiek纳米机械手的无缝集成,从而实现AFM,SEM以及EDS无缝组合。
本案例使用一种在硅基底上互相连接的8根电极作为测试电学性能表征的对象,实验装置包括使用纳米机械手有选择地偏置单个电极,同时进行导电AFM和EFM测量。使用FusionScope的侧向视野将两个纳米机械手放置在电极结构上,此外,导电悬臂尖端可以轻松地在探针尖端附近移动,并定位在每个电极结构上,可以同时对电极和导电AFM设置偏置电压。
使用两个纳米机械手放置于金电极样品表面,在偏置电极结构的顶部进行CAFM测量,金电极明显具有更高的电流信号,电流经过导电性差的Si基底,电流会逐渐降低到零。
使用两个纳米机械手放置于金电极样品表面,在偏置电极结构的顶部进行EFM测量,只有两个最内侧的电极是偏置的,在EFM测量期间,施加的偏置电压从+2V切换到-2V,如下图所示,由于施加偏置电压的切换,EFM信号显示出明显的相移。

纳米机械手辅助的CAFM&EFM表征
2) EBAC/EBIC表征
EBAC和EBIC做为高阶的故障点定位方法,通常需要配合纳米机械手使用。EBIC原理是当扫描电镜电子束作用于半导体器件时,如果电子束穿透半导体表面,电子束电子与器件材料晶格作用将产生电子与空穴。若该位置有电场作用(如晶体管或集成电路中的P-N结),电子与空穴在电场作用下将相互分离,空穴将向P型侧移动,电子将向N型侧移动,灵敏放大器可探测到的电流通过结区,可以实现高分辨成像掺杂区域形貌、确定掺杂区域大小,以及高分辨的进行PN结失效分析,快速定位到失效区域。
EBIC测量中观察到的图像分辨率取决于电子空穴对的生成范围、载流子扩散长度和缺陷处的载流子复合率。
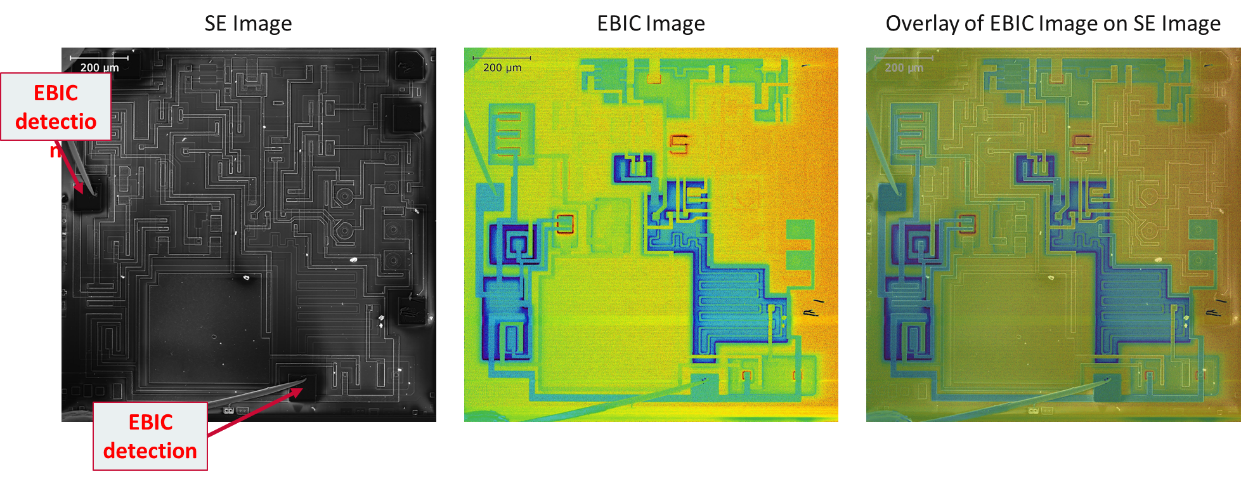
IC的EBIC表征
3) EFM表征
钛酸钡(BaTiO3)是一种非线性的正温度系数(PTC)材料,可用于电阻器。掺杂钛酸钡多晶的电阻具有温度依赖性,可用于传感器和致动器。多晶BaTiO3陶瓷的宏观电子特性受单个晶粒间形成的势垒控制。为了更好地了解钛酸钡的整体电阻,就必须能够在纳米尺度上表征晶体材料的电位差。这种表征可通过EFM实现。它广泛应用于电子开发,复杂的亚微米电子材料的电学面分布特性分析。
FusionScope使原位EFM分析成为可能:高分辨SEM用于轻松识别晶界,从而直接在感兴趣区域进行EFM分析。